Polysilizium Technologieplattform
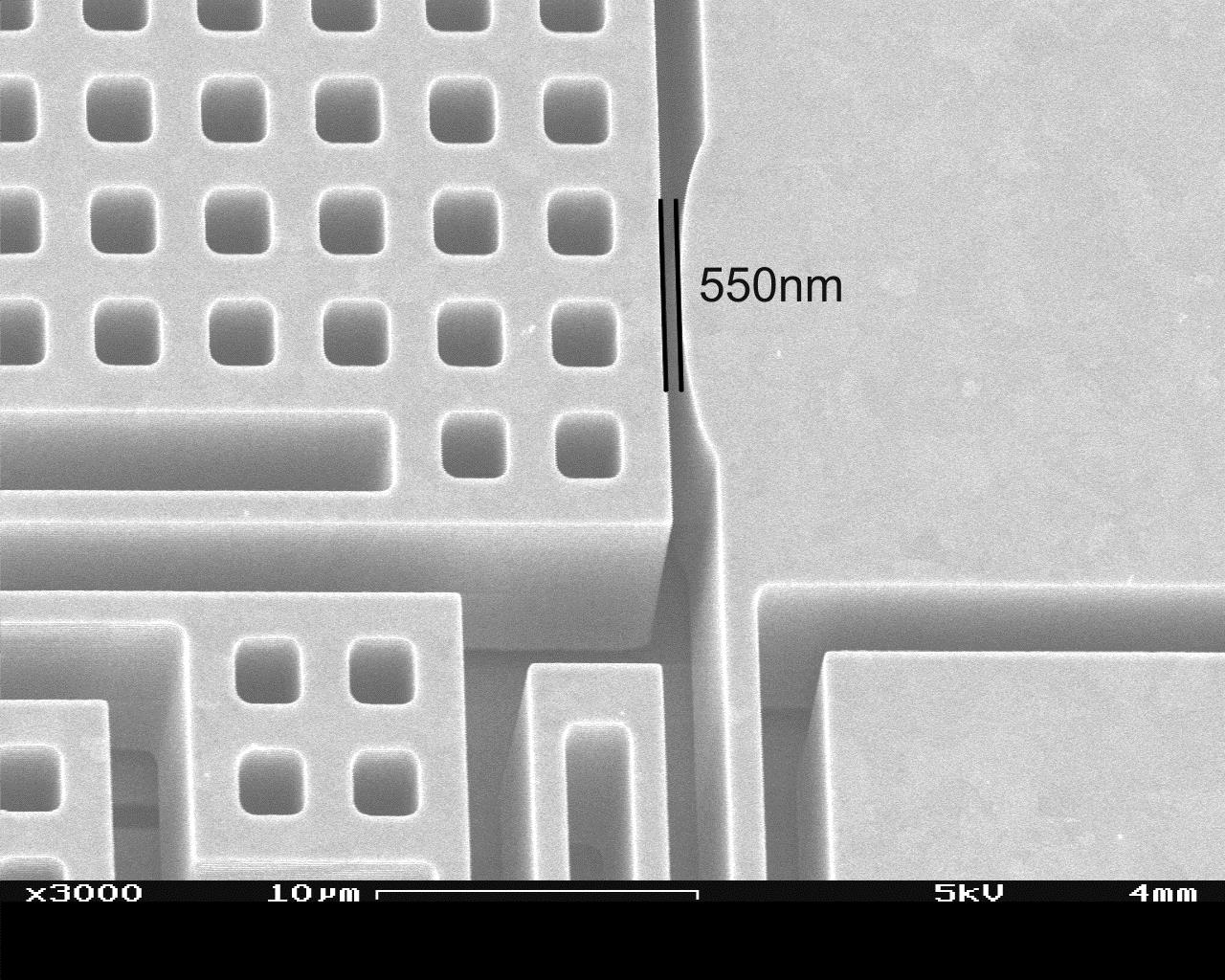

Im Prozess ist eine Verkapselung der Baulemente auf Wafer-Ebene integriert. Die feste Verbindung von Sensor- und Deckelwafer, das sog. Wafer-Level Packaging, wird hier durch ein Gold-Silizium Eutektikum bei rund 400°C erzeugt. Dabei sorgt der metallische Bondrahmen für eine hermetische Abdichtung, so dass der beim Verbindungsprozess eingestellte Druck über die gesamte Lebensdauer erhalten bleibt. Durch Integration einer Getterschicht kann ein Innendruck von bis zu 10-6 bar erreicht werden. Die Verwendung der neuartigen vom ISIT patentierten Multi Pressure WLP Technology erlaubt die Einstellung von unterschiedlichen Kavitätsinnendrücken auf Waferebene (großes Bild). Verwendung findet die PSM-X2 Plattform derzeit im Bereich der Inertialsensorik, der Mikrospiegel sowie Elektronen-optischen Ablenkeinheiten.
 Fraunhofer-Institut für Siliziumtechnologie
Fraunhofer-Institut für Siliziumtechnologie