Etablieren eines reproduzierbaren Dickdrahtbondprozesses für die Kontaktierung von Power-MOSFETs auf FR4-Substraten
Um das Know-How zum Thema Dickdrahtbonden von Leistungshalbleiterbauelementen auf FR4-Substraten am ISIT zu erweitern, wurde im Rahmen einer Mikrotechnologen Abschlussarbeit eine Machbarkeitsstudie für einen Dickdrahtbondprozess mit 500µm Al-Dickdraht durchgeführt. Mit Hilfe von Schertests und Querschliffanalysen wurden die gebondeten Verbindungen auf Scherfestigkeit und Rissbildung bewertet.
Schertests
Als Schertest wird ein zerstörendes Verfahren zur Analyse stoffschlüssiger Verbindungen (z.B. auf Substrate geklebte oder gelötete Bare-Dies, gelötete SMD-Bauelemente, Bump- oder Bonddrahtverbindungen) bezeichnet. Dabei fährt ein Schermeißel auf einer vordefinierten Höhe und mit vordefinierter Geschwindigkeit horizontal gegen die Probe und schert diese ab. Während des Scherprozesses wird die Kraft aufgezeichnet. Zur Verdeutlichung wird in der folgenden Darstellung von links nach rechts (Abbildung 1) der Scherablauf eines Goldbumps aufgezeigt., Wedgeverbindungen werden in gleicher Art geprüft.
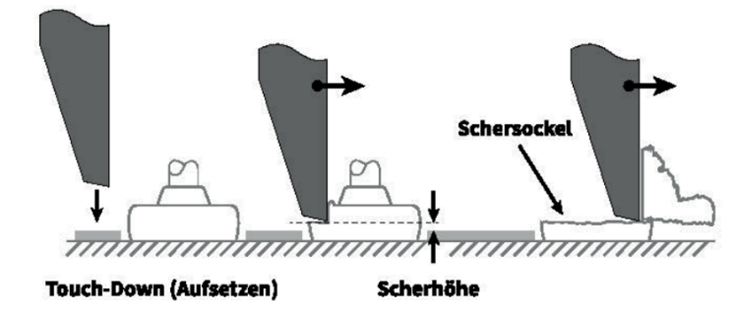
Querschliffanalyse
Die metallographische Schliffpräparation ist ein weiteres zerstörendes Untersuchungsverfahren. Dabei werden sowohl materialspezifische Eigenschaften wie z.B. die Korngrenzenausrichtung oder die Ausbildung der intermetallischen Phase von Gefügen als auch im Schadensfall, Risse im Inneren von Bauteilen, Lötstellen, oder mangelhafte Kontaktanbindung von Bauelementen betrachtet. Dafür werden die Proben in Kunstharz eingebettet, geschliffen und anschließend poliert, so dass die Probe anschließend unter einem Lichtmikroskop analysiert werden kann. Ein Beispiel für eine solche Probe ist in der nebenstehenden Abbildung (Abb.2) dargestellt.

Ergebnis
Zum Finden eines geeigneten Parametersatzes wurden die Bondparameter je nach Scherergebnissen erhöht oder verringert. Nach mehreren Bonddurchläufen mit verschiedenen Parametern wurde ein geeigneter Parametersatz ermittelt, mit dem es möglich ist, ein gutes Bondergebnis mit einer Scherfestigkeit über 35MPa sowie einer durchgängigen Anbindung zu den Anschlusspads für Testaufbauten zu realisieren. Im folgenden Bild (Abb.3) ist eine Reihe von Bondungen zu sehen, die die geforderten qualitativen Ansprüche erfüllen.
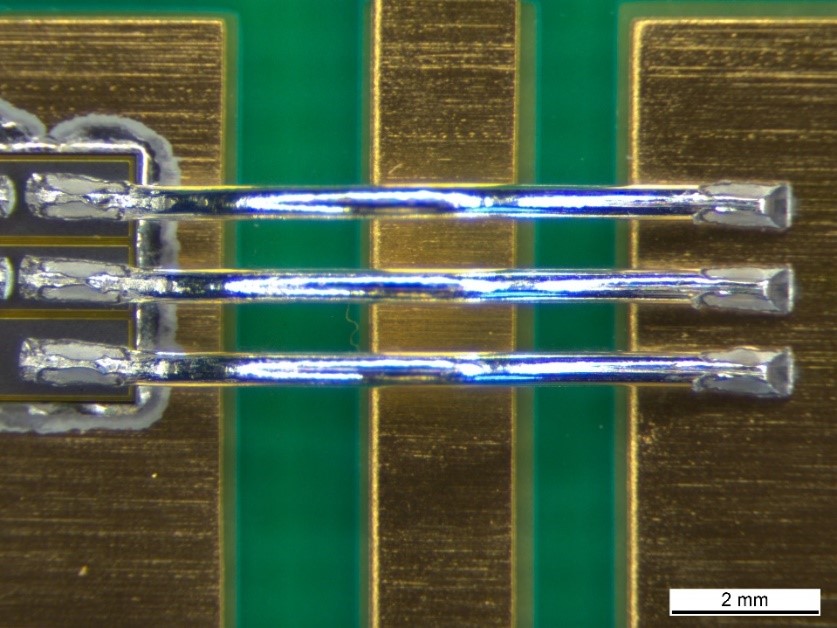
Fazit
Die Erkenntnisse, die im Verlauf der Arbeit gesammelt wurden, helfen zukünftig bei der Bewertung von Dickdraht gebondeten Aufbauten. Vor allem ist es gelungen, ein Bondprogramm zu entwickeln, das für zukünftige Anwendungen als Basis genutzt und durch Modifizierung auf die jeweilige Anwendung adaptiert werden kann.
Das ISIT bietet Technologieberatung und Unterstützung bei der Prozessevaluierung und Optimierung an. Gerne stehen wir Ihnen für individuelle Fragestellungen zur Verfügung.
 Fraunhofer-Institut für Siliziumtechnologie
Fraunhofer-Institut für Siliziumtechnologie